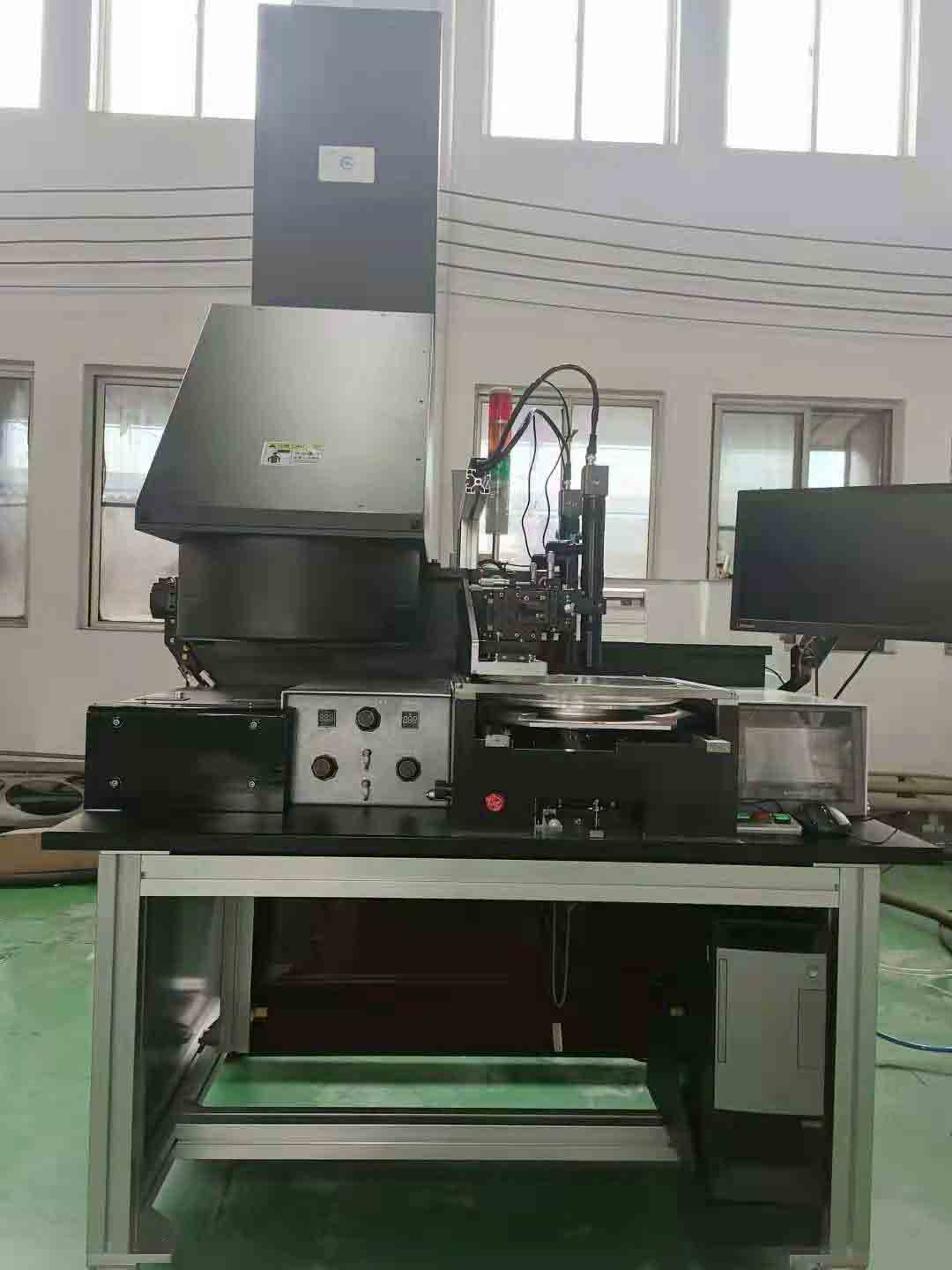
一、主要用途:
本設備是乙方專門(mén)針對各大專院(yuàn)校及(jí)科研單位(wèi)對光刻機的使用特(tè)性研發的一種精密光刻機(jī),它主要用於中小規模集成電路、半導體元(yuán)器(qì)件、光電子器件(jiàn)、聲表麵波器件的研製和生產(chǎn)。
二(èr)、 主要性能指標
1、曝光類型:單麵;
2、曝光麵積(有效麵積):φ310mm;
3、曝光照(zhào)度均勻性:≥ 96%;
4、曝光強度:0~30mw/cm²可調;
5、紫(zǐ)外光束角:≤3˚;
6、紫外光中心波長:365nm;
7、紫外光源壽命(mìng):2年;
8、曝光分辨率:2μm;
9、曝光模式:可選擇一次曝光或套刻曝光;
10、顯(xiǎn)微鏡移動範圍:X:±50mm Y:±100mm;
11、對準範圍:X、Y±3mm;Q±3°;
12、套刻精度:2μm;
13、分離量;0~50μm可調;
14、接觸-分離漂移:≤2μm;
15、曝光方式:密著曝光,可實現硬(yìng)接觸、軟接觸和微(wēi)力接觸曝光;
16、找平方式:三點式(shì)自動找平(píng); 8英(yīng)寸wafer;
17、顯微係統:雙視場CCD係統,顯微鏡91X~570X連續(xù)變(biàn)倍(物鏡1.6X~10X連續(xù)變倍),雙物鏡距(jù)離可調範圍50mm~120mm,計算機圖像處理係統(tǒng),19″液晶監視器(qì);計算機圖像處理係統,19″以上液晶監視器(qì);CCD用HMDI端口;
18、掩膜板尺(chǐ)寸: 355.6mm×355.6mm(12英寸wafer對應版);228.6mm×228.6mm(8英寸wafer對應版);
19、基片尺(chǐ)寸:φ304.8mm;
20、基片厚度:12英寸厚度775±20um;8英寸厚度725±20um;
21、曝(pù)光定時:0~999.9秒可調;
22、對準精度:±1μm;
23、曝光頭移(yí)動:電動;
24、電源:單相AC220V 50HZ ,功耗≤3KW;
25、潔(jié)淨空氣壓力:≥0.4MPa;
26、真空(kōng)度:-0.07MPa~-0.09MPa;
27、G-26D12型光刻機的組(zǔ)成:
由主(zhǔ)機(含機體和工作台),對準用單筒顯微鏡(jìng),高均勻性曝光頭組成。
28、附件如下:
a.主機(jī)附件:
1)掩膜版(bǎn)板架,按上麵第18提供。
2)真空夾持(chí)承片台,按(àn)以上提供。
b.顯微鏡組成
1)高分(fèn)辨(biàn)率單筒顯微鏡二個。
2)二個CCD。
3)視頻連接線。
4)計算機和19"液晶監視(shì)器(qì)。


 當前位置:
當前位置:


 熱門推薦
熱門推薦

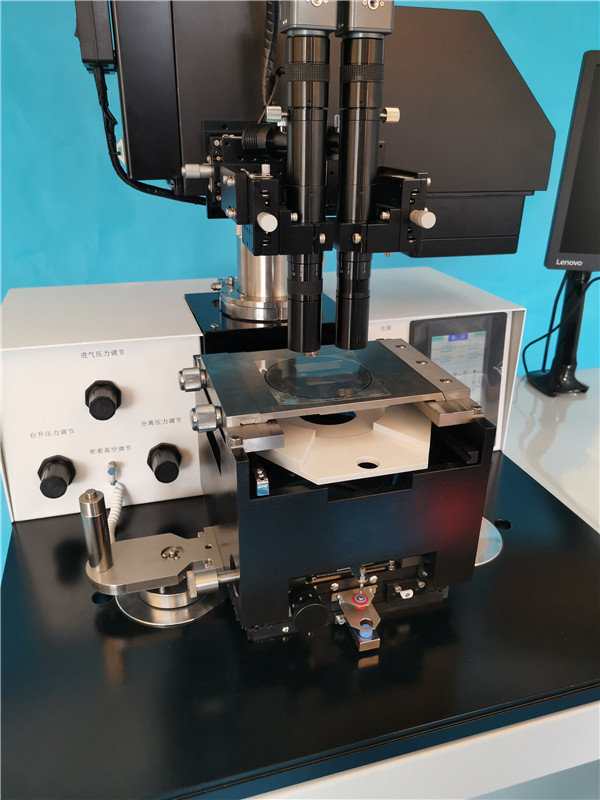
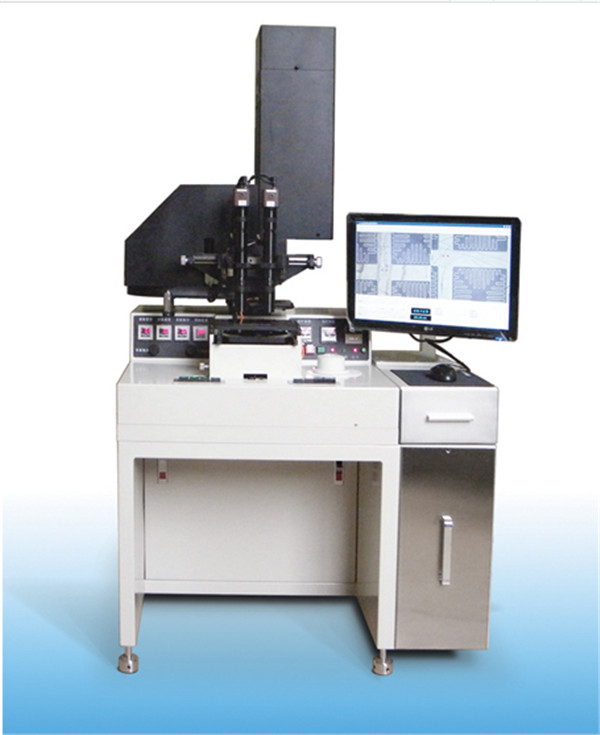
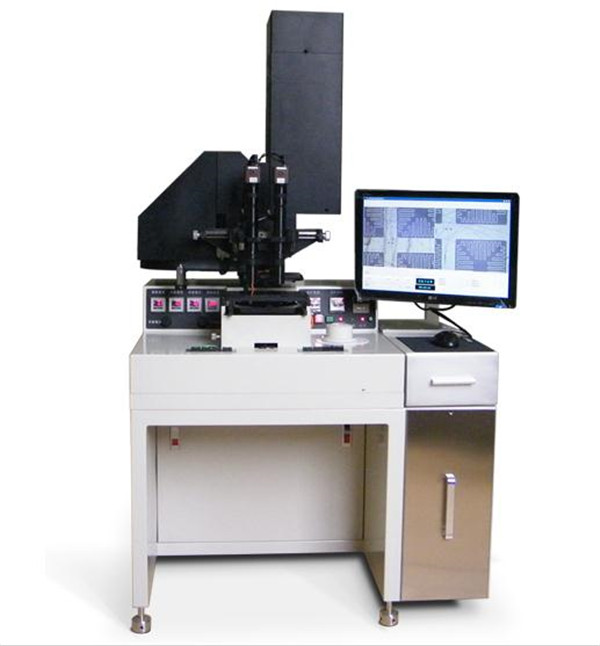


 推(tuī)薦新聞
推(tuī)薦新聞
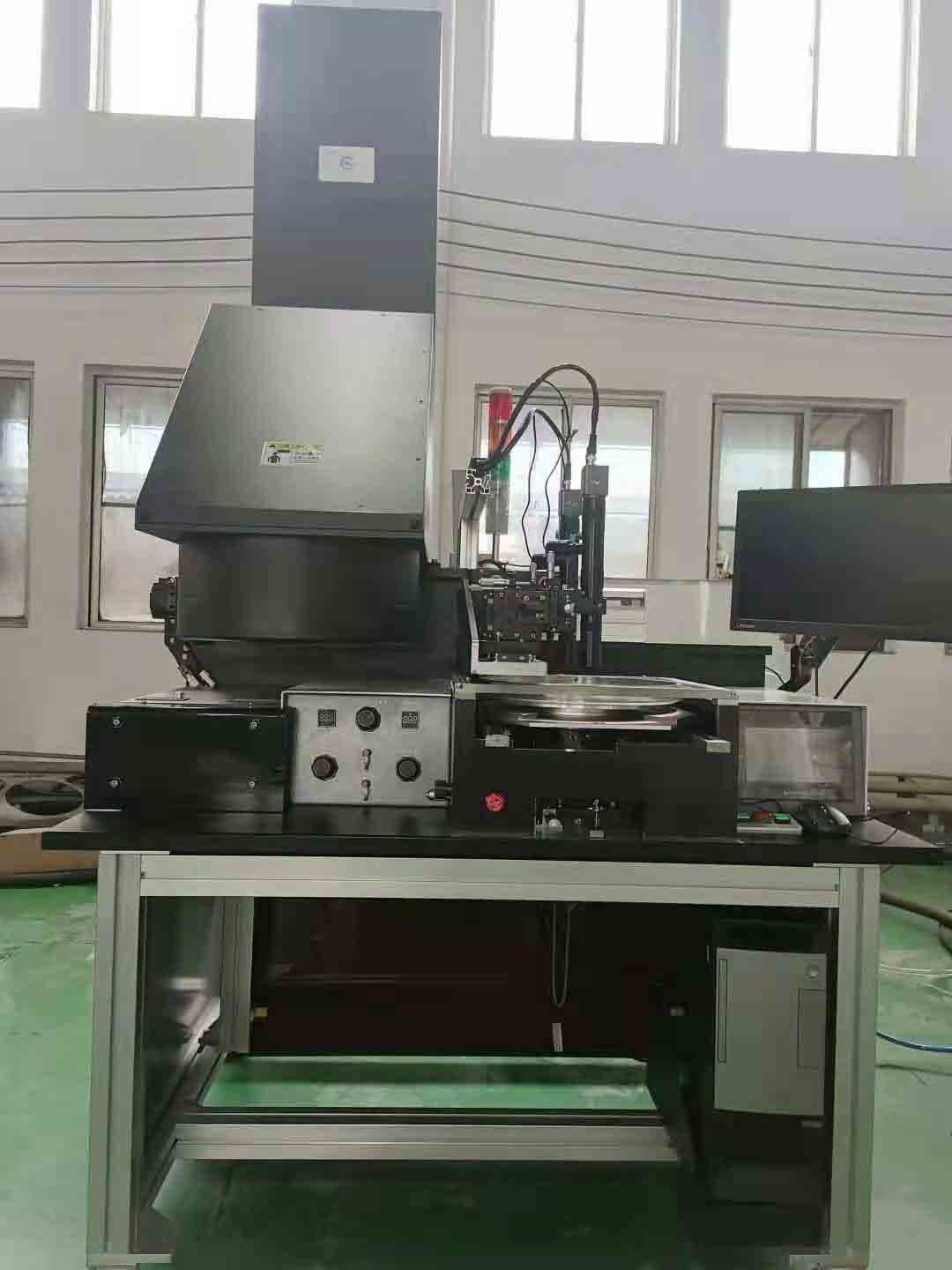
 在線留言
在線留言 詳情(qíng)內容
詳情(qíng)內容 



